Technologie der Prozesse CMOS
1) Oblate:
Der Entwurf eines Habens des Silikonscheibe Durchmessers, der zwischen 7,5cm und 23cm und minderwertige Stärke bis 1mm enthalten wird, wird mit einem Diamantblatt ein Silikonbarren zum einzelnen Kristall schneiden erreicht, der in seiner Umdrehung mit der Czochralski Methode erreicht wird. Insbesondere ist ein Silikonschmelzverfahren gehabtes policristallino, daß es scaldata in einem Tiegel mittels der Hochfrequenz kommt, das fixierte man kommt beibehalten zu 1425°C, das zu weniger vorgerückter Temperatur bis diese von Schmelzverfahren des Silikons ist, kommt in es eintauchte einen Silikonkristall, der die Richtung des erhaltenen Barrens feststellt, es kommt dann ruotato und extrahiert, den Barren mit Rhythmen der Zunahme zwischen 3cm/h und dem 18cm/h erzeugend.
2) Methoden der Oxidation der Oblate:
Die Oxidation der Oblate geschieht Heizung sie in einer oxidating Atmosphäre, insbesondere wird gehabt:
) trockene Oxidation: die Atmosphäre enthält nur Sauerstoff, von ihr ableitet einen langsamen Prozeß für velocizzare, das Temperaturen von ungefähr 1200°C benutzt werden.
B) Nasse Oxidation: die Atmosphäre enthält Dampf des Wassers, leitet ein Prozeß irgendein ausdrückliches für ab, welches eine Temperatur, die zwischen 900°C enthalten wird, genügend ist und 1000°C.però ein Oxid der unzulänglichen Qualität erreicht wird.
Das erhaltene Oxid hat eine Doppeltquantität des Volumens ungefähr betreffend ist das Volumen des verbrauchten Silikons und es erweitert ziemlich in beide vertikalen Richtungen.
3) Realisierung von Zonen mit verschiedenen Konzentrationen von impurità:
) Epitassia: gewachsen kommt einem Filmmonokristall, der die Oblate erhöhten Temperaturen und una drogaggio Quelle unterwirft.
B) Deposizione: verdunstete ein Material kommt das Droge Beimischen Droge Beimischen auf der Oberfläche des Silikons, um zu folgen hat einen thermischen Zyklus, der das impurità im Hauptteil zerstreut
c) Impiantazione: die Oberfläche Del silicon kommt bombardiert mit donori Atomen, oder Haben der accepters erhöhten Energie, zu vorgerückten Temperaturen zu 800°C hat das Verbreitung delle impurità zwischen verschiedenem, Zonen Dichte habend.
4) vorgewählte Verbreitung:
Die Fähigkeit zu fungieren stimmt von der Sperre in den dopanti Vergleichen des impurità zu, das von etwas Materialien eingeführt wird, die:
) zum fotoresist
B) polisilicio
c) Silikondioxid SiO2
d) Nitrat der silicio Sünde
Sie kommen insbesondere Gebrauch Sie zwecks zu verwirklichen der Schablonen, die die vorgewählte Verbreitung übereinstimmen.
5) Abbau des Oxids:
Das Oxid kommt bedeckt vom fotoresist, zu ihm, das es kommt, deckte sich einer mit Schablone in den Zonen, in denen sie, daß das Oxid bleibt (fotoresist…Positiv), solches Schablone protegge das fotoresist unten von den Lichtstrahlen wünscht, die UV sind und folglich sie nicht, was die anstatt für das nicht verdeckte fotoresist geschieht, das mit einem organischen Lösungsmittel entfernt werden kann, das geöffnete Fenster übereinstimmt folglich die Beseitigung unter des Oxids mittels einer Säure polymerisiert, mit der anstatt das fotoresist widersteht.
6) EBL:
Die Technik der Schablonen stimmt leider überein, Linien des gleichen minimalen Umfanges zu 0.8mm zu verwirklichen, während der Electrom Lichtstrahl übereinstimmt, zu 0.5mm anzukommen, Entwurf von einem, der präzisieren technisch sind viel und mit vielen Vorteilen aber auch von viel kostspieligem.
7) Polisilicio:
Das polisilicio ist eine Struktur im nicht monokristallinen Silikon, das erreichtes Niederlegen auf SiO 2ist , Entwurf eines Materials, das vom Schirm in den Vergleichen der Verbreitungen von impurità benommen wird und folglich es hauptsächlich verwendet anstatt des Metalls, um zu verwirklichen kommt, daß das Gatter eine des MOS mit dem folglich beizubehalten Ziel, zu Ihnen Quelle und Abfluß trennt, außerdem verringert das drogaggio von ihm den Widerstand zu den Werten viele Unterseiten. Droge beigemischtes Polisilicio kommt nicht anstatt verwendet, um Widerstände viel stark einen zu verwirklichen in den statischen Gedächtnissen.
8) ProzeßnMOS:
) mittels der aktiven Schablone SiO 2 von der Region wird beseitigt, wo der nMOS wird verwirklicht werden gewünscht
B) wird die Oxidgeldstrafe oder das Oxid vom Gatter niedergelegt, das eine Stärke ungefähr 100Å hat
c) legt das polisilicio nieder, das geht, das Gatter zu bilden eine
d) wird das Gatteroxid von von den Regionen beseitigt, in denen für impiantazione sie dann tiefer Verbreitungen n ungefähr 1m m undim Verhältnis zuder Quelle und dem Abfluß gekommenes zutreffendes sind
und) wird ein Oxid häufig niedergelegt und nachher sind die metallischen Kontakte der Quelle und dem Abfluß gekommenes zutreffendes
9) Typologie realizzative CMOS:
) zum Prozeßn-well
B) Prozeßp-well
c) Doppel-Wanne Prozeß
d) Prozeß-SOI
10) Prozeß-CMOS n-well:
) kommt es verwirklichte die Falle n bestimmt, um den pMOS unterzubringen
B) mittels der aktiven Schablone legen sie 2SiO und Sünde in den Regionen nieder, in denen der MOS werden verwirklicht werden gewünscht
c) kommt das Substrat p Droge beigemischtes p in der externen Zone zu dem, das sie den nMOS unterbringt und das wird sie von der Sünde umfaßt
d) kommt sie häufig gewachsenes Oxid in den Zonen, in denen nicht es Sünde gibt, gleichwohl wächst sie, ist vertikal, daß Platz zu einer Form seitlich, gebend zur Vogeltülle, die die aktive Region verringert, aber, sie die Struktur flach macht
und) eine geladene Schicht negativ ist vorzustellen zum Schnittstelle Oxid-Silikon, welches die Spannung von Schwelle V geändertes tsein kann, vom pMOS, der vom nMOS
f) das Oxid des Gatters wird und das polisilicio zu U niedergelegt in, wieviel das Gatter zwei anschließen muß eine
g) Sie kommen durchgeführte Verbreitungen n von nMOS und von p des pMOS
h) Sie kommen verwirklichen die Kontakte, das metalization und das passivazione zu Ihnen.
i) kommt das Substrat, das den nMOS unterbringt, angeschlossen an VSS, während das n-well, daß es den pMOS es unterbringt, angeschlossen an V DDkommt .
11) Eigenschaften von Prozeß-CMOS p-well:
Die Realisierung ist bis diese des CMOS n-well ergänzend jedoch, das betrachtet, daß der Transistor, der im Substrat verwirklicht wird, bessere Eigenschaft hat und daß der pMOS sie den minderwertigen Gewinn betreffend ist den nMOS haben, von ihr ableitet, die, wenn ein CMOS mit nMOS gewünscht wird und pMOS mit den ausgeglichenen Eigenschaften, wieviel möglichstes man zusammenkommen, um zu einem Prozeß CMOS p-well Zuflucht zu nehmen.
12) Doppel-Wanne Prozeß:
Eine epitassiale Schicht trennt Substrat n von der überhängenden Region, in der sie sind das n-well für den pMOS verwirklicht werden, daß das p-well für den nMOS, in solch einer Weise das latchup verhindert wird und MOS mit ausgeglichenen Eigenschaften erhalten werden.
13) SOI:
Mit dem Ziel, zum der Effekte des latchup zu verringern und der Geschwindigkeit zu erhöhen, ist das Technologie Silikon auf Isolierung entwickelt worden, wo die Isolierung im freundlichen zaffiro ist.
14) Verbesserungen der Technologie CMOS:
mit) hinzugefügt mehr Niveaus als Metall (…in den freundlichen verbundenen Schichten Aluminium zwischen sie mittels ÜBER) und vom polisilicio besseres stimmt shunting der Zuführungen überein und von ihm kennzeichnet sie geschweige denn insbesondere des Taktgebers
B) ist der Widerstand des polisilicio, das für das Gatter eine verwendet wird, von ungefähr 30mit , kann der Platz zu verzögert geben, im Kasten der langen Linien zu bestehen, folglich wird es bevorzugt, um Silicide, der polisilicio/tantalio oder eine gedeckte Schicht Silicide zu einer Schicht Silicide ist, in solch einer Weise zu benutzen der Widerstand 3 des Gatters, das eine auf mit verringertwird.
15) BiCMOS:
Entwurf eines Prozesses, in dem sie anwesendes Transistoren npn, pnp, nMOS sind, pMOS, ist es benutztes besonders laddove muß gesteuerte große Ladungen sein und ist Nachfragen, die niedrige Zeiten von verzögert, ist dieses als Beispiel der Kasten der Gedächtnisse und der gegebenen Busse von mdas processori.
16) Designrichtlinien:
Entwurf der Richtlinien Zeiten, die Grundregel zu erreichen, die im minimalen möglichen Bereich, zu solchen geometrischen Beschränkungen der Zielplätze auf den Schablonen und zu den Interaktionen zwischen den unterschiedlichen Schichten übertragen wird, können sie in der folgenden Form zwei zu Ihnen ausgedrückt werden:
) zu den Mikron-Richtlinien
B) L- Gründenrichtlinien können sie nicht unter dem m mbenutzt werden
17) entwirft einiges Richtlinien für Prozesse CMOS:
) muß das polisilicio dieses zum Ziel über der Region der Verbreitungen hinaus ausgedehnt sein, Kontakte zwischen Quelle und Abfluß zu vermeiden
B) die Schutzringe verhindern sie das latchup, insbesondere Entwurf von Verbreitungen p nel Substrat p, die anschlossen an V SS gekommenwerden, oder von Verbreitungen n nel Substrat n, die kommen, an V DDanschloß .
18) Ursprung und Entwicklung des latchup:
Das latchup ist es ein Phänomen, dem innen hinter die Entwicklung der Technologie CMOS verhindert hat, Entwurf tatsächlich eines Stromkreisparasiten, der im Prozeß CMOS angeboren ist, der unter günstiger Bedingungtür zum Kurzschluß zwischen VDD und VSS mit konsequenter Beschädigung der Vorrichtung CMOS, alle, daß es von der folgenden Abbildung wieder aufgenommen wird:
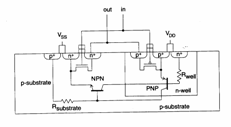 |
 |
||
Kurz gesagt, wenn gegenwärtig im emettitore der npn Dias eins, wird es zum Haben gekommen, das sein V= 0,7V folglich überschreitet in Übertragung und folglich wird schieben Strom auch im emettitore IST, vom Rest stellt der Fall aufR gut VSEIN = -0,7V für das pnp fest, das folglich es in der Übertragung auch folglich schiebt ulteriorly Strom im RSubstrat führt und folglich npn die Tür in Richtung zur Sättigung, dieses harte rigenerativo Effekt sinchè sich nicht oben den Auslöser-Punkt verfängt, über dem hinaus es in einem ist beständig diese Tür ist bis zu den holdingones, für die der Kurzschluß gehabt wird. Die Gründe, daß sie Platz zum latchup geben können, sind folglich im Wesentlichen extracurrents, die die, daß sie im I/O eingeführt werden können umkreist.
19) Methoden der Verhinderung des latchup:
) kann das b von den zwei Transistoren verringert werden, die auf Ihnen geschmückt werden
B) quellen die Werte der Widerstände R hervor und Rkann verringertes Substratsein
c) kann von den Schutzringen eingesetzt werden, die sie wie erfundene Sammler fungieren, die die Minoritätstützen aufsaugen folglich, die den Gewinn des npn und des pnp senken.
d) wird viel Rauschgiftsüchtigdose selbst ein Substrat gebildet und es mit einer epitassiale Schicht, in solch einer Weise zu bedecken verringert den Wert des Widerstandes des Substrates
und) kann das R gut mittelsein das verringerte Schicht leggermente Rauschgiftsüchtige sein, das zu einem Schichtschweren Droge beigemischt gedeckt wird.